积体电路製造需要某种隔离工艺将单个器件隔离开来。因为半导体积体电路是在同一块半导体硅片上,通过平面工艺技术製造许多元件和器件(如电阻、电容、二极体、三极体等),并按需要将它们连线在一起,形成具有一定功能的电路。这些元件和器件所处的电位不同,相互之间必须绝缘隔离,否则半导体本身的电导将这些元件相互连通,就不可能在一个单晶片上製作积体电路。为此,必须设法使它们在电性能方面隔离开来,这就是隔离工艺所要达到的目的。衡量隔离工艺模组的指标有:密度、工艺複杂度、成品率、平坦化程度和寄生效应。在这些指标间存在着折中。常用的器件隔离方法有PN结隔离、LOCOS隔离、沟槽隔离。
基本介绍
- 中文名:器件隔离
- 外文名:Device Isolation
PN结隔离
pn结隔离是积体电路生产中比较常用的方法,特别是在一些无特殊要求的小规模积体电路中。它是利用pn结反向偏置时呈高电阻性,来达到各元件互相绝缘隔离的目的。实现隔离有多种方法,但用得最多的还是一次外延、二次扩散pn结隔离工艺,简称标準pn结隔离或pn结隔离。
为了实现pn结隔离,衬底材料必须选用p型单晶,以便和n型外延层之间形成pn结。这一pn结击穿电压的大小主要取决于衬底电阻率的高低。从提高击穿电压和减小隔离结寄生电容考虑,衬底的电阻率高一点好。但选得过高,在长时间的隔离扩散中,会增加外延层向衬底的推移,使隔离时间加长。同时高阻的单晶较贵,因此电阻率不能取得太高,在一般电路中为8到13欧姆厘米。为了得到平坦均匀的扩散结面,还应选用 晶向的硅单晶。厚度一般为300到350微米,应选用位错密度较低(一般应小于3000个/平方厘米),有害杂质少的硅单晶片。
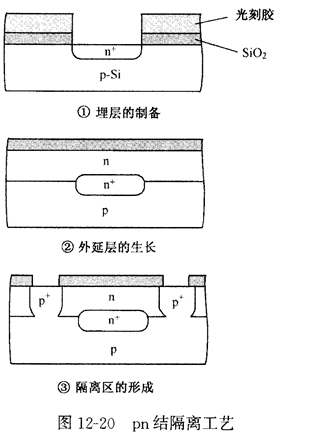
图1 PN结隔离工艺
LOCOS隔离
传统的硅局部氧化(Local Oxidation of Sillicon, LOCOS)隔离技术是利用光刻刻蚀技术在硅基板上的氮化硅上开出氧化视窗,利用氮化硅的掩模作用在大约1000摄氏度的高温下对没有氮化硅覆盖的场区进行氧化。氧化后氧化层表面将高出硅基板表面,高度大约是氧化膜厚度的55%,形成一定程度的不平坦表面,给后续工艺带来不利影响。再者,氧化生长时,横向的氧化生长将向器件的有源区延伸,形成所谓的“鸟嘴”现象。“鸟嘴”的出现,不但占据了一定的有源区面积,而且在极小尺寸下,使得漏电流问题越来越突出,极大地影响到器件的性能。

图2 LOCOS隔离的鸟嘴效应
沟槽隔离
沟槽(Shallow Trench Isolation, STI)隔离技术起源于80年代,由于它的高成本和工艺的不成熟性,直到最近一两年才被人们所接受。该工艺是一种完全平坦的、完全无“鸟嘴”现象的新型隔离技术。其工艺流程如图所示,隔离技术完全迴避了高温工艺;严格保证器件有源区的面积;硅基板表面与隔离介质表面完全在同一平面上;改善了最小隔离间隔和结电容。同时,低温工艺也可以潜在地增加产量,降低成本。这些优点使得STI隔离成为深亚微米时代器件不可或缺的隔离技术。STI隔离主要适应极小尺 寸器件对极小特徵尺寸、器件可靠性的要求。在 极小尺寸下,要求场区和有源区的面积非常小; 同时,对器件的漏电流也极为敏感。STI隔离工艺 主要有以下各关键工艺:氧化和氮化硅生长、沟壑光刻刻蚀、HDP High Density Plasma,高密度电浆)二氧化硅生长、二氧化硅CMP Chemical Mechanical Planarization)、氮化硅去除 等工艺步骤。
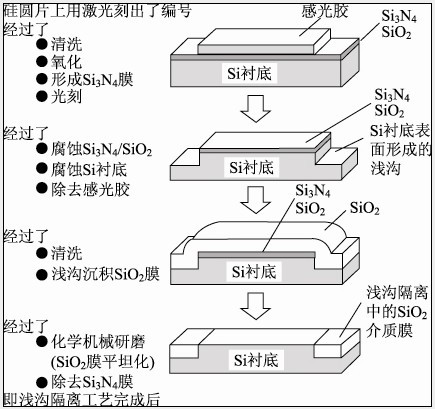
图3 沟槽隔离工艺步骤